继先进制程激战之后,英特尔、台积电和三星又将战场扩大至3D先进封装领域,最近各自均开始了新的部署,开发更为先进的封装技术。其中贯彻IDM 2.0战略的英特尔,近期首次曝光了其在马来西亚的封装与测试计划。
据DigiTimes报道,英特尔APJ总经理Steven Long表示,英特尔将加快进军先进封装领域,继美国俄勒冈州和新墨西哥州后,马来西亚的封装和测试工厂也将进行扩建,预计明年将开始投产,到2025年末,三期厂房总计Foveros 3D先进封装产能将比2023年增加四倍。对于在马来西亚的半导体投资,英特尔不会感到陌生,已经有超过50年的历史。
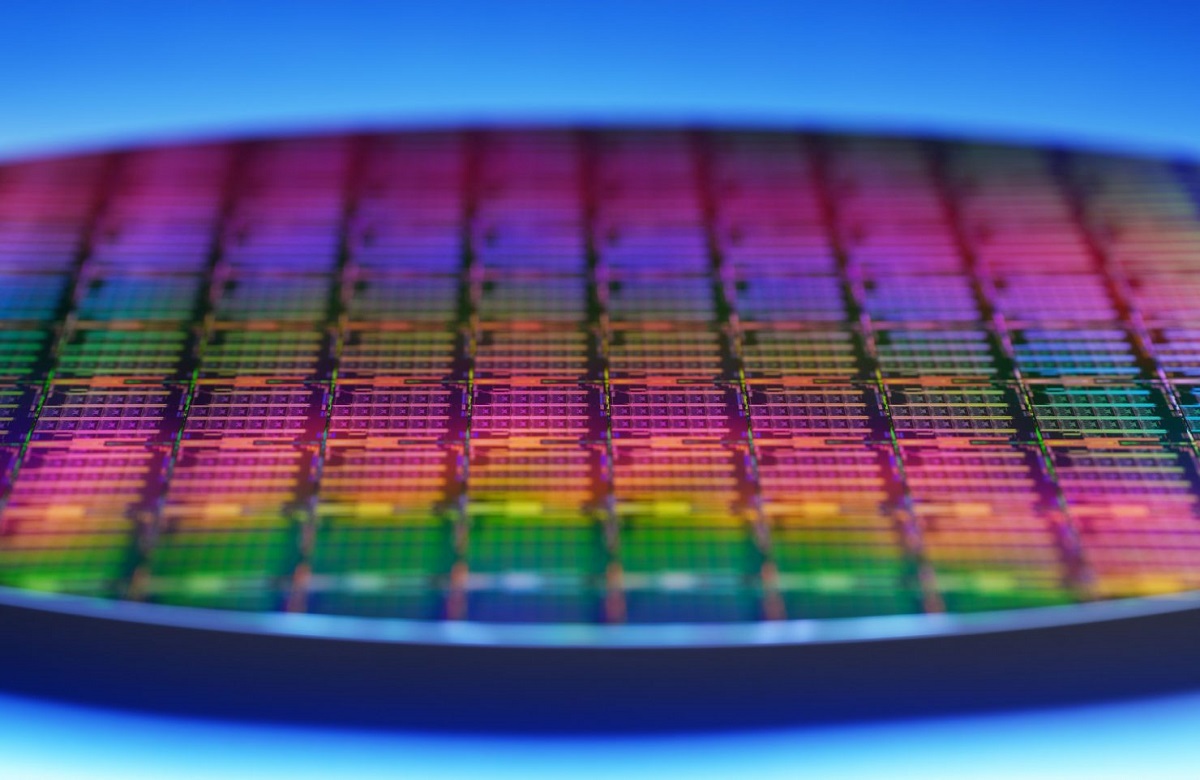
由于先进制程工艺已逼近物理极限,接下来先进封装技术可能成为半导体制造工艺的胜负关键,晶圆代工厂都希望能提供覆盖前端和后端的完整服务,投下巨资研发先进的2.5/3D封装技术,将日月光等传统的封装与测试厂阻隔在外。其中台积电就稳稳地夺下了不少先进封装订单,比如英伟达H100 GPU,采用了CoWoS封装,即便产能不足,其他厂商也只能取得少量订单。
台积电去年还启动了3D Fabric联盟,为半导体设计、存储器模块、基板技术、测试、制造和封装提供全方位的一流解决方案和服务。AMD接下来多款芯片采用了Chiplet设计,都会在台积电以SoIC搭配CoWoS量产。此外,苹果也在规划SoIC搭配InFO的封装方案,最快会在2025年量产,也将由台积电负责。
据了解,英特尔目前已在马来西亚投资了80亿美元,下一阶段还会再投资60亿美元,将再建造一座3D先进封装厂和一座测试厂。目前亚马逊AWS已成为首家采用英特尔代工服务(IFS)封装解决方案的客户,近期还与EDA大厂Synopsys合作,更好地为Intel 3/18A制程节点服务。英特尔还完成了封装整合光学讯号传输,光元器件透过EMIB连接,提升频宽并降低功耗。