将芯片从2D平铺封装改成3D立体式堆叠式封装已经成为目前半导体业界的共识,这种在第三维度上进行拓展的封装技术能够有效降低整个芯片的面积,提升集成度。目前业界领头羊都在3D封装技术上面努力着,前有台积电的CoWoS(实际上是2.5D),后有Intel的Foveros,现在三星也公布了自家的3D封装技术,名为X-Cube。
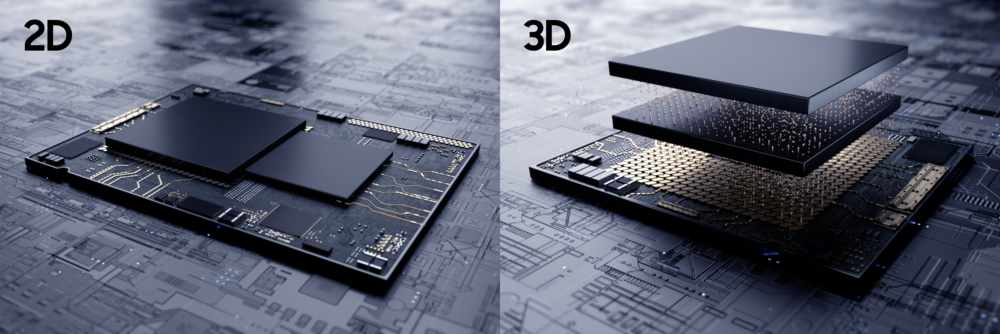
X-Cube的全称是eXtended-Cube,意为拓展的立方体。在Die之间的互联上面,它使用的是成熟的TSV工艺,即硅穿孔工艺。目前三星自己的X-Cube测试芯片已经能够做到将SRAM层堆叠在逻辑层之上,通过TSV进行互联,制程是他们自家的7nm EUV工艺。三星表示这样可以将SRAM与逻辑部分分离,更易于扩展SRAM的容量。另外,3D封装缩短了Die之间的信号距离,能够提升数据传输速度并提高能效。
X-Cube可灵活应用于未来芯片之上,包括5G、AI和高性能计算等领域的芯片均可使用该技术。三星表示X-Cube已经在自家的7nm和5nm制程上面通过了验证,计划和无晶圆厂的芯片设计公司继续合作,推进3D封装工艺在下一代高性能应用中的部署。三星将会在下星期的Hot Chips峰会上公布关于X-Cube的更多信息。
在三星推出X-Cube之后,全球主要的三家半导体代工厂均已经拥有3D或2.5D的封装技术了,显而易见的是,未来我们买到的电子产品中,使用3D封装技术的芯片比例会越来越高。
游客 2020-08-14 18:06
该评论年代久远,荒废失修,暂不可见。
支持(0) | 反对(0) | 举报 | 回复
3#
超能网友博士 2020-08-13 20:09 | 加入黑名单
该评论年代久远,荒废失修,暂不可见。
已有2次举报支持(3) | 反对(2) | 举报 | 回复
2#
超能网友终极杀人王 2020-08-13 13:03 | 加入黑名单
该评论年代久远,荒废失修,暂不可见。
已有3次举报支持(5) | 反对(2) | 举报 | 回复
1#